掩埋金线叠DIE封装
掩埋金线叠DIE封装
随着电子产品日趋便利化,对产品要求也趋小型、薄型化。即对现有的封装器件要求更小,更薄,而产品本身的内容却又不断在增加。如何在这种矛盾的条件下实现全部要求?这对整个封装行业提出了新的发展。
封装行业小型化发展有CSP、BGA等方向,本文从叠DIE的角度介绍Package小型化的方式。
封装流程Substrate → 贴装元件 → 贴DIE → 引线键合 → 塑封 → 切割→ 外观检查 → 测试 → 包装
封装形式● 平面贴DIE方式(图1) 平面式

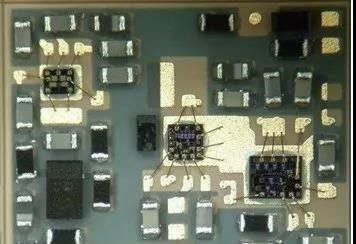
● 垂直贴DIE方式(图2) DIE之间直接相贴,阶梯式 DIE之间间隔一层spacer
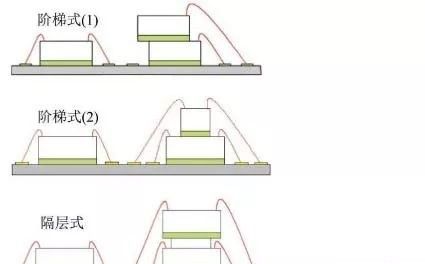
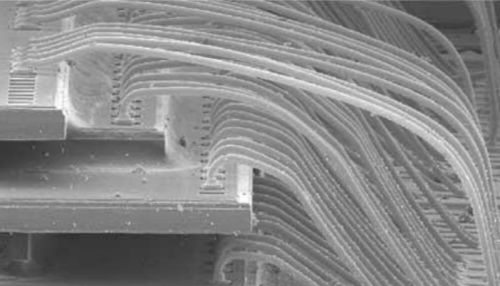
两种方式的受限之处平面贴DIE方式:多个DIE布局在同一平面,最大程度的占据了封装空间,难以满足尺寸受限制的条件。
垂直贴DIE方式:阶梯式(1)的叠DIE方式相对平面式的情况有所降低空间利用,但在多层同一类型DIE阶梯时,同样会占据较多空间,因为每递增一层,相当于DIE的尺寸增加约500um,当DIE数量多达8个时,则会增大500×8=4000um的空间。对尺寸紧凑条件,也是难以满足。
阶梯式(2)方式需求所叠层的DIE尺寸比下层的DIE尺寸小,这样才可以让出Wire bonding的空间,应用范围受限。
隔层方式在两层DIE之间增加一层Dummy DIE,留出高度用于Wire bonding,增加工艺流程,材料成本,降低UPH。
新型贴DIE方式新型的贴DIE方式综合了垂直方式中的两种优势(掩埋式)(图3)。
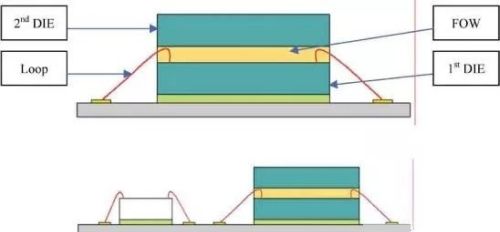

该方式采用一种新型的材料,名称为FOW (film on wafer,如图4),利用film attach技术粘附在DIE的bottom面,所粘DIE可直接attach在其它DIE之上,位置没有要求,即可以直接压附着下层DIE的loop。(多个同种DIE可以完全重合在一起,极大缩小了叠DIE占据的空间)


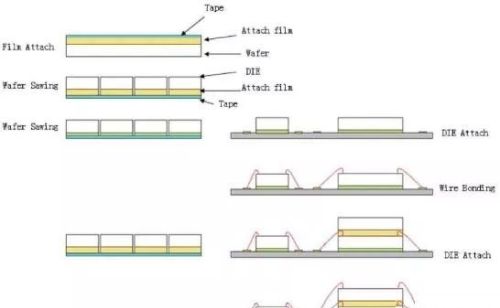
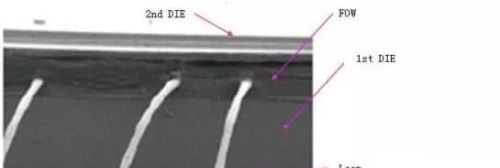
其使用条件、使用流程及效果图分别示于图5~7。
该方式的优势在于多个大小相同的DIE叠加在一起,所占据的空间为一个DIE所占据的空间,大大的节约了水平空间。对size要求严的产品是一个好的选择。size的减小同时也可以减低产品的成本。
叠加多层DIE时,Wire bonding完成后可直接贴装上一层DIE,而不需要增加一个隔层Spacer。缩短生产流程与降低外在因素影响,提高UPH。该方式可有效解决PACKAGE内包含多个DIE,而水平空间又受到约束的情况。随着器件小型化程度加快,此方式的应用也将普及。